This document discusses MOS transistor theory and provides examples for calculating threshold voltage (VT).
[1] It describes the basic structure of an n-channel MOSFET and the energy band diagrams for different biasing conditions, including accumulation, depletion, and inversion.
[2] Threshold voltage depends on factors like gate material, oxide thickness, channel doping, and interface charges. An example calculates VT0 = 0.38V for an nMOS transistor with given parameters.
[3] Body effect is explained, where threshold voltage increases with reverse substrate bias. An example plots VT as a function of VSB, using the body effect coefficient γ = 0.85V1/2 calculated for the

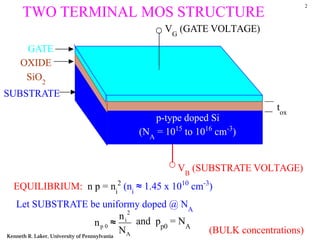



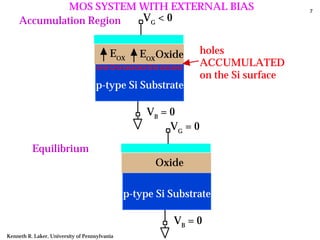







![MOS Capacitance C = WLC , C = ε ox 15
[tox -> TOX in SPICE]
GC ox ox
t ox
[Cox -> COX in SPICE]
tox = 50 nm, εox = 0.34 pF/cm => Cox = 6.8 x 10-8 F/cm2
W x L = 50 µm x 50 µm => CGC = 170 fF
Depletion Capacitance C BC = WLC j , C j = εSi
xd
[NSUB -> NSUB in SPICE]
NSUB (p - substrate)
kT n i
ln φFp =
q NA
NA = 3 x 1017 cm-3, ni = 1.45 x 1010 cm-3 => φF = -0.438 V
(recall that at room temp or 27oC kT/q = 26 mV)
VSB = 0 V, εSi = 1.06 pF/cm, q = 1.6 x 10-19 C, NA, φF => xd = 6.22 µm
εSi, xd => Cj = 0.17 x 10-8 F/cm2
W x L = 50 µm x 50 µm => CBC = 42.5 fF
Kenneth R. Laker, University of Pennsylvania](https://image.slidesharecdn.com/ee560mostheoryp101-130309152641-phpapp02/85/Ee560-mos-theory_p101-14-320.jpg)
![16
Threshold Voltage for MOS Transistors
n-channel enhancement
For VSB = 0, the threshold voltage is denoted as VT0 or VT0n,p T0 -> VT0 in SPICE]
[V
QB 0 Q ox
VT 0 = ΦGC − 2φF − −
C ox C ox
Threshold Voltage factors: (+ for nMOS and - for pMOS)
[2φ F = PHI in SPICE]
-> Gate conductor material;
-> Gate oxide material & [N A = NSUB in SPICE]
thickness;
-> Channel doping;
-> Impurities in Si-oxide
interface;
ΦGC = φF(substrate) -φM metal gate
ΦGC = φF(substrate) -φF (gate) polysilicon gate
-> Source-bulk voltage Vsb;
-> Temperature. [Qox = qNSS in SPICE]
Kenneth R. Laker, University of Pennsylvania](https://image.slidesharecdn.com/ee560mostheoryp101-130309152641-phpapp02/85/Ee560-mos-theory_p101-15-320.jpg)
![17
Threshold Voltage for MOS Transistors
n-channel enhancement
For : the threshold voltage is denoted as VT or VTn,p
QB Q ox
VT = ΦGC − 2φF − −
C ox C ox
Q B 0 Q ox Q B − Q B0
= ΦGC − 2φF − − −
C ox C ox C ox
where VT0
(γ = Body-effect coefficient) [γ = GAMMA in SPICE]
+
Kenneth R. Laker, University of Pennsylvania](https://image.slidesharecdn.com/ee560mostheoryp101-130309152641-phpapp02/85/Ee560-mos-theory_p101-16-320.jpg)