The document discusses design for testability in CMOS VLSI design, emphasizing the importance of testing throughout the design process. It covers various topics such as testing strategies, fault models, and methodologies like scan and built-in self-test to enhance observability and controllability. The document concludes with the necessity of planning for testing from the beginning to ensure functionality post-fabrication.









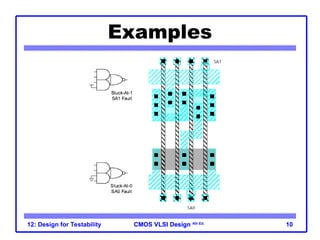








![CMOS VLSI Design
CMOS VLSI Design 4th Ed.
12: Design for Testability 19
PRSG
Linear Feedback Shift Register
– Shift register with input taken from XOR of state
– Pseudo-Random Sequence Generator
Flop
Flop
Flop
Q[0] Q[1] Q[2]
CLK
D D D
Step Y
0 111
1 110
2 101
3 010
4 100
5 001
6 011
7 111 (repeats)
Flops reset to 111
Y](https://image.slidesharecdn.com/lect12-test-240914095716-03c7c86d/85/Test-generation-in-VLSI-design-and-Testing-19-320.jpg)
![CMOS VLSI Design
CMOS VLSI Design 4th Ed.
12: Design for Testability 20
BILBO
Built-in Logic Block Observer
– Combine scan with PRSG & signature analysis
MODE C[1] C[0]
Scan 0 0
Test 0 1
Reset 1 0
Normal 1 1
Flop
Flop
Flop
1
0
D[0] D[1] D[2]
Q[0]
Q[1]
Q[2] / SO
SI
C[1]
C[0]
PRSG
Logic
Cloud
Signature
Analyzer](https://image.slidesharecdn.com/lect12-test-240914095716-03c7c86d/85/Test-generation-in-VLSI-design-and-Testing-20-320.jpg)





