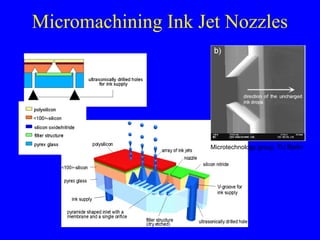
Ink Jet Nozzels
- 1. Micromachining Ink Jet Nozzles Microtechnology group, TU Berlin
- 2. CNT Based Gas Sensor
- 5. NEMS Switch Fabrication (a) Silicon chip with 500 nm of thermally grown oxide, 20 nm of tungsten, and PMMA. (b) Electron beam lithography was used to define features in the PMMA layer. An ICP etch was used to pattern the tungsten and etch down into the oxide. (c) A Cr/Au layer was evaporated and lifted off by removing the tungsten. (d) DEP was performed to assemble a small bundle of nanotubes traversing the trench between the two side electrodes.
- 6. Carbon Nanotube for Adhesion Measurement
- 8. Accelerometers Types of Accelerometers How Surface Micromachined Capacitive Accelerometers Work Tilt Sensing with Accelerometers
- 9. Accelerometer • An accelerometer measures proper acceleration, which is the acceleration it experiences relative to freefall and is the acceleration felt by people and objects. • Conceptually, an accelerometer behaves as a damped mass on a spring. When the accelerometer experiences an acceleration, the mass is displaced to the point that the spring is able to accelerate the mass at the same rate as the casing. The displacement is then measured to give the acceleration. • In commercial devices, piezoelectric, piezoresistive and capacitive components are commonly used to convert the mechanical motion into an electrical signal.
- 10. Types of Accelerometers Peizo-film – used in AC applications to sense motion, sound, temp. and pressure Surface Micromachined Capacitive – used in DC applications to measure tilt, vibration, and inertial
- 11. Types of Accelerometers Bulk Micromachined Capacitive – used in DC applications to measure tilt, vibration, and inertial Electromechanical Servo – DC applications to measure tilt and inertial Piezo-electric – AC applications to measure vibration and shock
- 12. How It Works – Surface Micromachined Capacitive Suspended Beam held in place by tethers Acceleration in either direction caused movement in the beam With movement of beam, capacitance between plates changes The difference is measured and the direction and force are determined
- 13. Tilt Sensing Accelerometer measures the static gravity field Acceleration of 9.8m/s = 1g Changing the tilt (along the sensitive axis) changes acceleration vector
- 14. ADXL202AE Operating Temperature – -40 to 85°C Voltage – 3.0 to 5.25V Current – Typical 0.6mA Max 1.0mA Output – Digital – Duty Cycle Modulated or Analog Weight – less than 1 gram
- 15. Accelerometers are used to measure the motion and vibration of a structure that is exposed to dynamic loads Human activities – walking, running, dancing or skipping Working machines – inside a building or in the surrounding area Construction work – driving piles, demolition, drilling and excavating Moving loads on bridges Vehicle collisions Impact loads – falling debris Concussion loads – internal and external explosions Collapse of structural elements Wind loads and wind gusts Air blast pressure Loss of support because of ground failure Earthquakes and aftershocks
- 16. Pressure Sensor
- 17. Presentation Overview 1. Pressure Sensor Theory Overview 2. Pressure Sensor Process Overview and Fabrication Theory Review
- 18. 18 Physical principles of pressure sensing Static pressure: defined as the force exerted perpendicularly on a unit area Volume pressure: defined as mass per unit volume Liquid pressure: e.g a person lies inside then bathtub
- 19. 19 Typical characteristics of piezoelectric transducers Transfer function Sensitivity: the change in output resulting from a change in input -33pC/bar Operating temperature range: -20 to 350 degrees Measuring range: 0 to 300 bar (non-SI unit, like Pa)
- 20. Pressure Sensors •Absolute – A Sensor That Measures Input Pressure in Relation to a Zero Pressure. •Differential – A Sensor That Is Designed to Accept Simultaneously Two Independent Pressure Sources. The Output Is Proportional to the Difference Between the Two Sources.
- 21. Pressure Sensor Theory Two Main Types of Pressure Sensors Capacitive Sensors • Work based on measurement of capacitance from two parallel plates. • C = εA/d , A = area of plates d = distance between. • This implies that the response of a capacitive sensor is inherently non-linear. Worsened by diaphragm deflection. • Must use external processor to compensate for non-linearity
- 22. Pressure Sensor Theory Piezoresistive Sensors Work based on the piezoresistive properties of silicon and other materials. Piezoresistivity is a response to stress. Some piezoresistive materials are Si, Ge, metals. In semiconductors, piezoresistivity is caused by 2 factors: geometry deformation and resistivity changes. Reference: http://en.wikipedia.org/wiki/Piezoresistance_Effect
- 23. Pressure Sensor Theory Our Sensor is a Piezoresistive Sensor based on a Wheatstone Bridge Configuration. Resistors are made with Boron Diffusion.
- 24. Pressure Sensor Theory Vout =Iin*∆R Why use a Constant Source Bridge? Produces Linear Output Neglects Lead Resistance R + ∆R R - ∆R R - ∆R R + ∆R
- 25. Pressure Sensor Process Overview Initial Wafer is 525 µm thick, n-type, <100> double-side polished (DSP).
- 26. Pressure Sensor Process Overview – Step 1 What should ALWAYS be step 1? Wafer Cleaning (RCA Clean) Steps 1. TCE (Tetrachloroethylene) Immersion, Acetone, Methanol 2. Base Clean - H2O/H2O2/NH4OH (5 parts,1 part,1 part) @ 70 C to Remove Organic Contaminants 3. Dilute HF Immersion (2.5%) Why? 4. Acid Clean - H2O/H2O2/HCl (4 parts, 1 part, 1 part) @ 70 C to remove metallic and ionic contaminants.
- 27. Pressure Sensor Process Overview – Step 2 Any guesses? Thermal Oxidation Wet Oxidation Followed by Dry Oxidation Si + O2 → SiO2 (Dry Oxidation) Si + 2H2O2 → SiO2 (Wet Oxidation)
- 28. Pressure Sensor Process Overview – Step 3 Photolithography for Piezoresistive Elements Contact Lithography Use Shipley 1813 Positive Resist What happens to areas exposed to UV light in Positive Resist? Si + O2 → SiO2 (Dry Oxidation) Si + 2H2O2 → SiO2 (Wet Oxidation)
- 29. Pressure Sensor Process Overview – Step 3 Cont. DNQ Method using Mercury Lamp Diazonap. Changes to carboxylic acid via Wolf re-arrangement Carboxylic Acid is more soluble in a base than Novolak. So exposed areas dissolve. Use TMAH (a base) mixture to develop Ref: http://chem.chem.rochester.edu/~chem421/polymod2.htm
- 30. Pressure Sensor Process Overview – Step 4 - Diffusion Creates Resistors in Substrate Three Methods 1. Solid Evap. (Tetramethyl Borate, Boron Nitride) - Rare 2. Gaseous – Diborane (B2H6) – Dangerous!! 160 ppm for 15 min life threatening 3. Liquid – Our Type PBF-6MK – Borosilicate polymer in ethanol. Creates borosilicate glass, boron oxide, and unused boron. 5 Squares 1 Square 3Squares Ref: Jaeger, Richard. “Introduction to Microelectronic Fabrication”
- 31. Pressure Sensor Process Overview – Step 5 – Backside Photlithography Windows Must Be Opened in New Oxide For Backside Etch. Use Front to Backside Alignment Etch Silicon Dioxide w/BOE (HF 6:1) Finished when wafer is hydrophobic (water rolls off)
- 32. Pressure Sensor Process Overview – Step 6 – Backside Etch Need 20 µm Thick Diaphragm, therefore must etch approx. 500 µm. TMAH/IPA KOH 25% wt. TMAH 45% wt KOH 17% vol IPA 70o C 75o C {100} 12 µm/hr 21 µm/hr {111} 0.7 µm/hr < 0.05 µm/hr SiO2 <0.01 µm/hr < 0.20 µm/hr Ref: Crain, Mark. “Powerpoint Thesis Defense”
- 33. Pressure Sensor Process Overview – Step 8 Metal Deposition and Pattern Several Methods, we use Sputtering 2 Types (Magnetron) -RF Sputter -DC Sputter http://en.wikipedia.org/wiki/Sputtering
- 34. Pressure Sensor Process Overview – Photolithography and Aluminum Etch First Photoresist is deposited on metal and patterned for desired traces Uses Aluminum Etch, 85-95% Phosphoric Acid, 2- 8% Nitric Acid, and Water.
- 36. Pressure Sensor Process Overview – Wire Bonding and Packaging Several Types – Ball, Wedge, etc. Heated gold wire is pressed onto surface, melted, and then cooled.
- 37. 37 Applications of pressure sensors Touch screen devices Automotive industry Biomedical Aviation Marine industry
- 38. Thank You