This document discusses recent advancements in the analysis of conformality of films produced by atomic layer deposition (ALD), emphasizing its significance for semiconductor device fabrication. It offers a historical perspective on conformality studies, introduces new terminology such as 'hole-equivalent aspect ratio,' and outlines key modeling fundamentals. The document also highlights recent experiments and results related to thickness profiles and kinetic information in ALD processes.





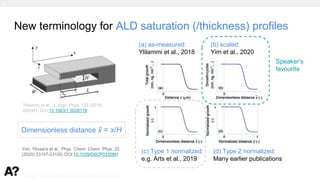

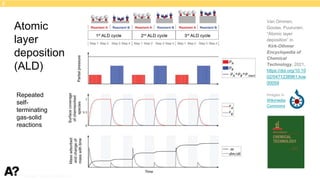

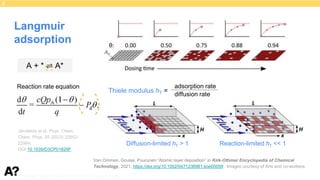

![Puurunen - invited, AVS 69, Nov 5-10, 2023, Portland, Oregon
~Ten years of PillarHallTM LHAR
www.pillarhall.com
1st gen prototype [ 2nd gen ] 3rd gen, LHAR3 4th gen, LHAR4
Tekes (Business Finland) proj. PillarHall
Academy of Finland (now Research Council of Finland) proj. ALDCoE
Trademark ~2015
PillarHallTM
Customers, investors etc. → →
www.chipmetrics.com
Dr. Mikko Utriainen
Puurunen
Professor
2017 →
Aalto
Univ.
2 scientific articles
1st: Gao et al. 2015
DOI:10.1116/1.4903941
[ 0 articles ]
>20 scientific articles for LHAR3+LHAR4
“LHAR3 core paper”: Yim, Ylivaara et al., 2020
DOI:10.1039/D0CP03358H
ALD Stories
Podcast Ep. 14
3.](https://image.slidesharecdn.com/2023-11avs69-2023-11-07used-231108234551-ab4c4581/85/Puurunen-invited-AVS69-ALD-conformality-pptx-12-320.jpg)

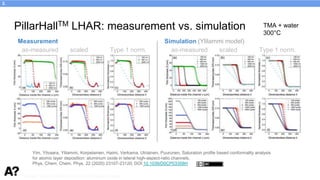



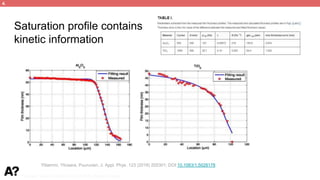
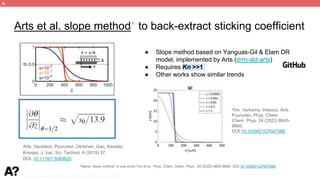
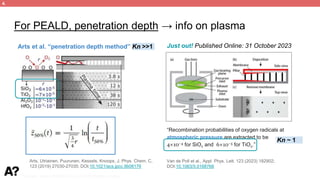


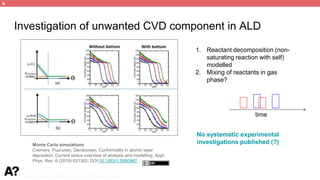




![Puurunen - invited, AVS 69, Nov 5-10, 2023, Portland, Oregon
https://youtu.be/xOYrCjcVTzA?si=1djvKC
Gx4AkFfzoU
(INVITED) Fundamentals of atomic layer
deposition: an introduction (“ALD 101”)
ABSTRACT:
Atomic layer deposition (ALD) has become of global importance
as a processing technology for example in semiconductor device
fabrication, and its application areas are continuously expanding.
The significance of ALD was highlighted e.g. by the recent
(2018) Millennium Technology Prize. Tens of companies are
offering ALD tools, and thousands of people are involved in ALD
R&D globally. A continuous need exists to educate new people
on the fundamentals of ALD.
While ALD for manufacturing may be regarded mature, as a
scientific field, ALD—in the author’s view—is developing. For
example, understanding of the early history of ALD is evolving,
related to the two independent inventions of ALD under the
names Atomic Layer Epitaxy in the 1970s and Molecular
Layering in the 1960s [1-4]. Also, significantly varying views exist
in the field related to the description and meaningfulness of even
some core ALD concepts [5].
<continues…>
extras](https://image.slidesharecdn.com/2023-11avs69-2023-11-07used-231108234551-ab4c4581/85/Puurunen-invited-AVS69-ALD-conformality-pptx-28-320.jpg)








