Embed presentation
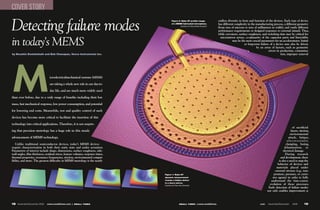


This document discusses failure mode detection in microelectricalmechanical systems (MEMS). MEMS devices come in endless forms and functions, each with their own manufacturing complexity, geometry, and performance requirements. Initial or long-term failure of a device can be caused by a variety of factors like geometric errors, contamination, improper removal of layers, stiction, environmental attack, fatigue, electrostatic clamping, fusing, delamination or electrical damage. Precision metrology plays a huge role in advancing MEMS technology by enabling early detection of failure modes, which allows improvements to the next fabrication process and helps fully understand how devices and materials degrade over time under external stresses.